Artificial IntelligenceNews
TSMC CoPoS: Evolusi Canggih Packaging 310×310 mm untuk Era AI

TSMC memperkenalkan teknologi CoPoS (Chips-on-Panel-on-Substrate), generasi lanjutan packaging dari CoWoS, yang menggunakan substrat persegi 310×310 mm—lebih dari 5× luas area dibanding wafer bundar tradisional. Ini memungkinkan integrasi chiplet GPU dan hingga 12 modul memori HBM4 dalam satu paket besar, mendukung peningkatan performa AI dan HPC.
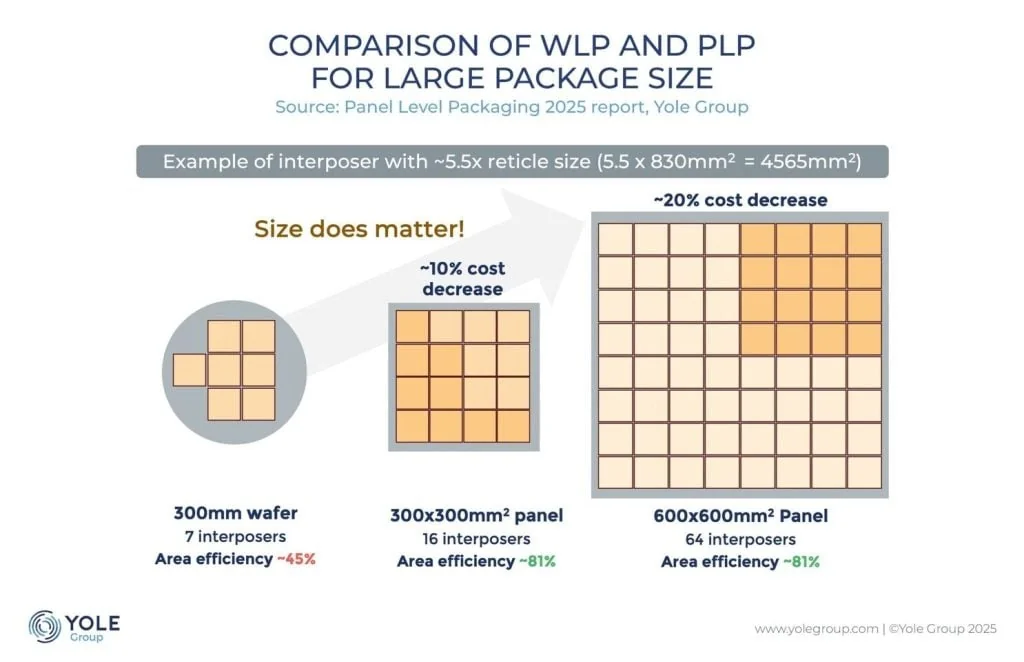
🚀 Peta Jalan Inovasi TSMC
- 2026: Pembentukan pilot line CoPoS di unit Visionchip TSMC.
- 2027: Penyempurnaan proses di pilot line, target siap untuk kebutuhan mitra.
- Akhir 2028–awalk 2029: Produksi massal CoPoS dimulai di pabrik baru AP7 Chiayi—terintegrasi dengan lini multi-chip module dan SoW/SoP.
🔧 Keunggulan Packaging Panel-level (PLP)
- Efisiensi produksi: substrat besar memudahkan through-put tinggi dan cut-cost dibanding packaging wafer-level (WLP) .
- Integrasi ultradense: menampung banyak HBM4 + chip GPU di satu panel—ideal untuk workload AI yang membutuhkan memori lebar dan compute tinggi.
- Potensi teknologi lanjut: kompatibel dengan substrat kaca, photonik silikon, dan kemasan 3D stack generasi mendatang .
🌐 Dampak & Kolaborasi Strategis
- NVIDIA menjadi mitra peluncur utama CoPoS, menggunakan paket besar untuk GPU Blackwell dan akselerator AI.
- AMD & Broadcom tetap menggunakan CoWoS-L/R untuk produk high-end mereka, sambil menyiapkan potensi migrasi ke CoPoS di masa depan.
- Pusat packaging AP7 Chiayi diisyaratkan sebagai hub mapping multi-phase, dengan tahap awal WMCM, SoIC, lalu CoPoS di phase 4.
✅ Kesimpulan
CoPoS mewakili lompatan besar dalam evolusi packaging chip: menggunakan panel persegi besar, mendongkrak densitas memori dan compute dalam satu paket. Dengan roadmap mall produksi pada 2028‑29 di AP7 Chiayi, TSMC membekali NVIDIA dan mitra global untuk menghadirkan akselerator AI ultra-kinerja dan efisiensi tinggi—mempersiapkan era baru desain chip modular besar dan hemat biaya.
Sumber:
- TechPowerUp: TSMC Siapkan CoPoS Packaging 310×310 mm
- TrendForce dan MoneyDJ: Pilot line 2026, mass production 2028‑29 AP7 Chiayi, NVIDIA principal
- Digitimes & eeworld: Manfaat panel-level packaging & substrat kaca/plastik










